发布时间:2024-02-05 05:52:32 来源:乐鱼官网入口
HBM(HighBandwidthMemory)即高带宽存储器,用于GPU与CPU之间的高速数据传输,主要使用在场景集中在数据中心高性能服务器的GPU显存,小部分应用于CPU内存芯片。HBM同样为3D结构,由多层DRAMdie垂直堆叠,每层die通过TSV(Through Silicon Via)穿透硅通孔+μbumps技术实现与逻辑die连接,再通过中阶层与GPU/CPU/SoC连接,使得4层、8层、12层等数量die封装于小体积空间中。
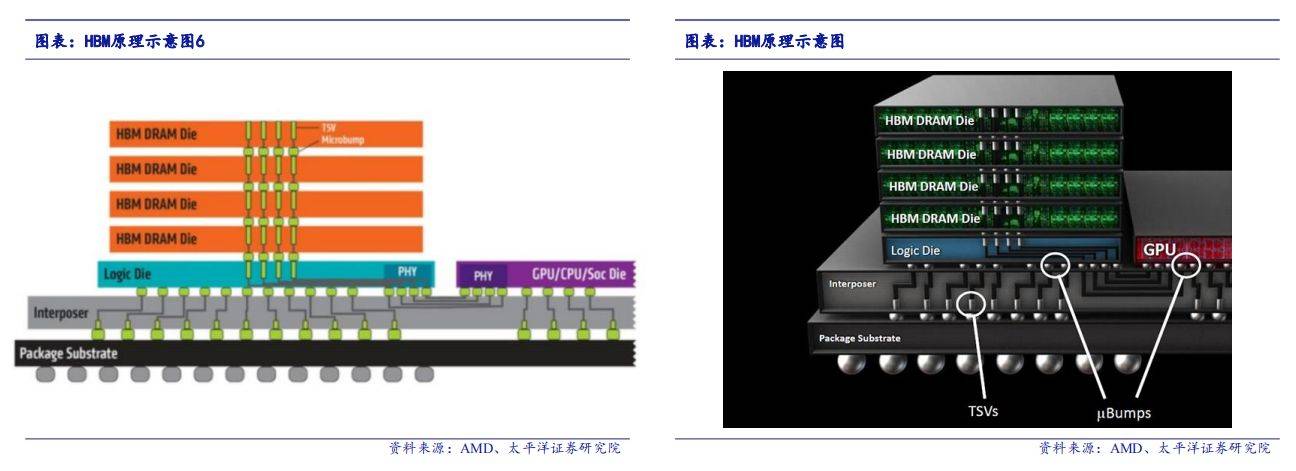
目前主流显卡使用的显存为GDDR5,但在应用中仍存在痛点:1)消耗大量PCB面积:GPU核心周围分布12/16颗GDDR5芯片,而GDDR芯片尺寸无法继续缩小,占据更大空间,同时也需要更大的电压调节模块,2)GDDR5的功耗提升达到了对GPU性能提升产生负面影响的拐点:由于平台和设备需要在逻辑芯片与DRAM之间的实现功耗平衡,而当前GDDR进入功能/性能曲线的低效区,一直增长的内存功耗在未来会阻碍GPU性能提升。
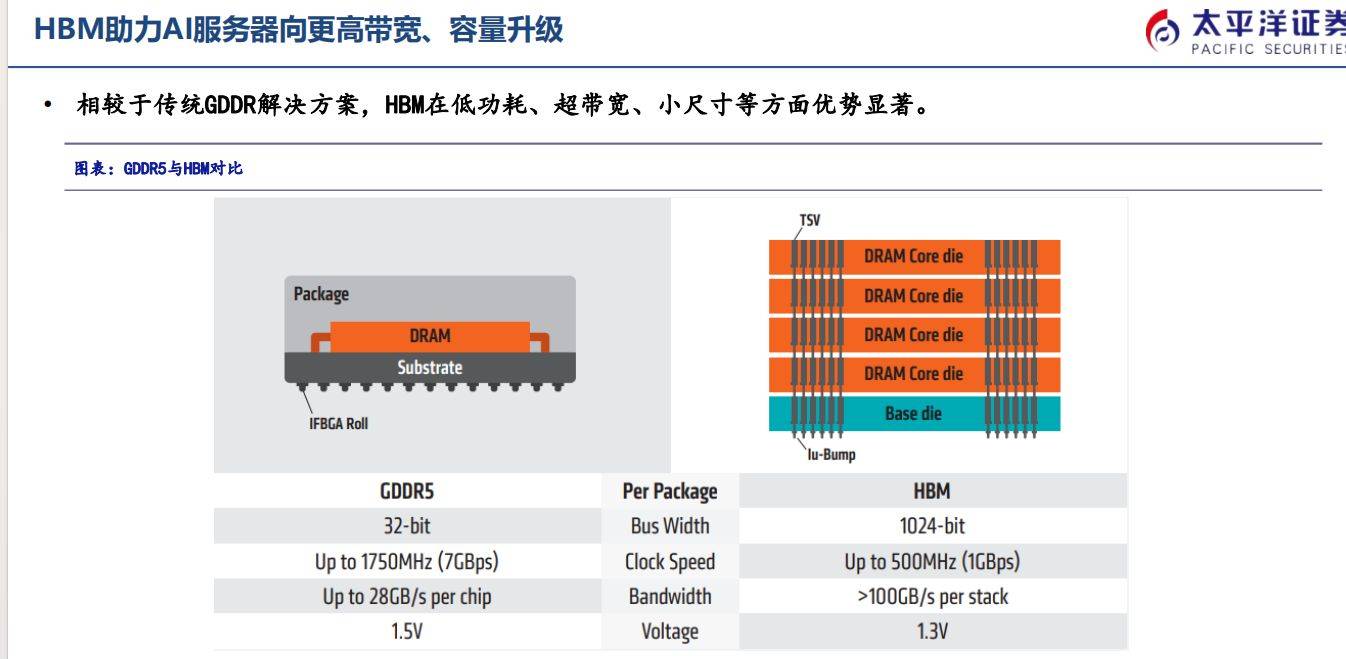
HBM因其高带宽、低功耗、小体积等特性,大范围的应用于AI服务器场景中。HBM的应用大多分布在在高性能服务器,最早落地于2016年的NVP100GPU(HBM2)中,后于2017年应用在V100(HBM2)、于2020年应用在A100(HBM2)、于2022年应用在H100(HBM2e/HBM3),最新一代HBM3e搭载于英伟达2023年发布的H200,为服务器提供更快速度及更高容量。

AI服务器出货量增长催化HBM需求爆发,经测算,HBM 2025年市场规模将超过150亿美元,增速超50%。全球服务器增虽长较为稳健,但随着大数据模型训练需求AI服务器出货量呈爆发式增长,2022年AI服务器出货量86万台,渗透率不断的提高,AI服务器在整体服务器占比10%左右,预计2026年AI服务器出货量将超过200万台,预计年复合增速29%。同时,主流AI服务器HBM容量需求从40GB向80GB、141GB升级,带动平均HBM容量提升。我们测算,2025年HBM全球市场规模将达到150亿美元,同比增速68%。

HBM供给厂商主要聚集在SK海力士、三星、美光三大厂,SK海力士领跑。三大存储原厂主要承担DRAMDie的生产及堆叠,展开技术升级竞赛,其中SK海力士与AMD合作发布全球首款HBM,23年率先供应新一代HBM3E,先发奠定市场地位,主要供应英伟达,三星供应其他云端厂商,根据TrendForce数据,2022年SK海力士市占率50%、三星市占率40%、美光市占率10%左右,2023年SK海力士市占率预计为53%,三星市占率38%、美光市占率9%。

存储原厂加码HBM产能,SK海力士24年产能计划翻倍。SK海力士HBM3E将于24年上半年量产,目标24年HBM产能翻倍,24年资本支出规划虽与23年基本持平,但TSV相关投资将同比增加一倍以上。美光HBM3E将于24年初开始量产,预计24年资本支出75-80亿美元,同比略高,大多数都用在HBM量产。三星规划在天安厂新封装线,用于大规模生产HBM,预计追加投资7亿美元。
HBM在封装工艺上的变化主要在CoWoS和TSV。1)CoWoS:是将DRAMDie一同放在硅中介层上,通过过ChiponWafer(CoW)的封装制程连接至底层基板上,即将芯片通过ChiponWafer(CoW)的封装制程连接至硅晶圆,再把CoW芯片与基板连接,整合成CoWoS。当前,HBM与GPU集成的主流解决方案为台积电的CoWoS,通过缩短互连长度实现更高速的数据传输,已大范围的应用于A100、GH200等算力芯片中。

HBM在封装工艺上的变化主要在CoWoS和TSV。2)TSV:TSV硅通孔是实现容量和带宽扩展的核心,通过在整个硅晶圆厚度上打孔,在芯片正面和背面之间形成数千个垂直互连。在HBM中多层DRAMdie堆叠,通过硅通孔和焊接凸点连接,且只有最底部的die能向外连接到存储控制器,其余管芯则通过内部TSV实现互连。
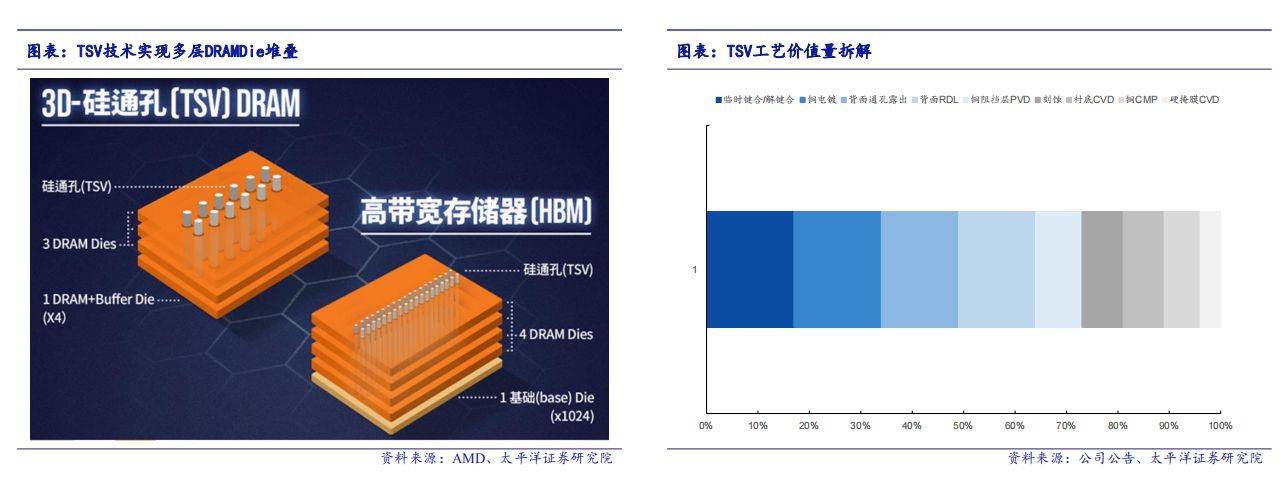
通富微电:公司具备国内顶级2.5D/3D封装平台及超大尺寸FCBGA研发平台,并且完成高层数再布线技术开发,为客户提供晶圆级和基板级Chiplet封测解决方案,已量产多层堆叠NAND Flash及LPDDR封装,是国内首家完成基于TSV技术的3DS DRAM封装开发的封测厂。公司通过收购AMD苏州及AMD槟城各85%股权,实现与大客户AMD深度绑定,AMD于2023年推出MI300,并于23Q4陆续降幅,预计24年将迎来大幅放量,公司将充分受益。
长电科技:公司与客户共同开发基于高密度Fanout封装技术的2.5DfcBGA产品,TSV异质键合3DSoC的fcBGA通过认证。公司的封测服务覆盖DRAM、Flash等,深耕行业20余年,在16层NANDflash堆叠、35um超薄芯片制程能力、Hybrid异型堆叠等方面行业领先。公司XDFOI技术平台布局AI、5G、汽车、工业等领域运用,XDFOI Chiplet量产。
太极实业:公司子公司海太半导体与SK海力士签订5年合作协议,SK海力士持有海太半导体45%股权,海太与SK海力士形成深度绑定,海太为SK海力士提供DRAM封装服务。SK海力士23年占据HBM市场约50%份额,伴随24年HBM出货量爆发,公司有望承接溢出封测需求。• 深科技:公司通过收购沛顿科技切入存储封测,沛顿科技专注高端封测,具备DDR5、LPDDR5封测量产能力。沛顿Bumping项目已通过小批量试产,聚焦FC倒装工艺、POPt堆叠封装技术的研发、16层超薄芯片堆叠技术的优化。
赛腾股份:公司通过收购全球领先的晶圆检测设备供应商日本OPTIMA进军晶圆检测装备领域,公司产品涉及固晶设备、分选设备,晶圆包装机、晶圆缺陷检验测试机、倒角粗糙度量测、晶圆字符检测机、晶圆激光打标机、晶圆激光开槽机等,通过OPTIMA切入三星、 SK siltron、sumco等大客户供应链,三星加码24年资本开支,计划24年HBM产线年的一倍以上,量测设备需求增加,公司有望受益。
中微公司:公司为国内刻蚀设备龙头,其中ICP刻蚀设备在DRAM、3D NAND多个客户的生产线量产,伴随NanovaVE HP和Nanova LUX推出,ICP刻蚀设备的验证工艺范围持续扩展,在先进逻辑芯片、先进DRAM和3D NAND的ICP验证刻蚀工艺覆盖率有望扩展到50%-70%不等。公司8英寸、12英寸的Primo TSV 200E、Primo TSV 300E在晶圆级先进封装、2.5D封装和微机电系统芯片生产线D芯片的硅通孔刻蚀工艺上得到成功验证。
拓荆科技:公司在半导体薄膜设备领域深耕十余年,ALD量产规模逐步扩大,随着存储芯片主流制造工艺已由2D NAND发展为3D NAND结构,结构的复杂化导致对于薄膜沉积设备的需求量逐步增加,同时3D NAND FLASH芯片的堆叠层数不断增高,从32/64层逐步向更多层及更先进工艺发展,对于薄膜沉积设备的需求提升的趋势亦将延续
雅克科技:公司于2016年通过收购控股UP Chemical,正式切入前驱体行业,UP Chemical自04年成为SK海力士前驱体核心供应商,形成多年深度绑定。SK海力士HBM占据50%市场占有率,并且于22Q3起向英伟达独供HBM3。公司产品覆盖硅类前驱体、High-K 前驱体、金属前驱体,伴随HBM需求量增加,SK海力士出货量提升,公司将充分受益。
联瑞新材:公司深耕无机填料和颗粒载体行业近40年,为国内硅微粉龙头。公司持续聚焦高端芯片AI、5G、HPC封装,异构集成先进封装Chiplet、HBM,以及新一代高频高速覆铜板,推出多种规格低CUT点Low微米/亚微米球形硅微粉,低CUT点Lowα微米/亚微米球形氧化铝粉,高频高速覆铜板用低损耗/超低损耗球形硅微粉,新能源电池用高导热微米/亚微米球形氧化铝粉。
壹石通:公司布局记忆体封装用Low-α高纯石英及Low-α高纯氧化铝制备技术、Low-α粉体制备技术、球形化生产的基本工艺等核心技术,已具备Low-α射线球形氧化铝的产业化能力。公司规划新建的年产200吨高端芯片封装用Low-α球形氧化铝项目,有望在2023年下半年实现部分投产,目前日韩客户已陆续送样验证,客户初步反馈良好。Low-α球形氧化铝粉体在EMC或GMC中的体积填充率大约在80%-90%,有望受益HBM出货量增加。
华海诚科:公司为国内环氧塑封材料龙头,在先进封装领域,公司已成功研发了应用于QFN/BGA、FC、SiP、FOWLP/FOPLP 等封装形式的封装材料。GMC颗粒状环氧塑封料能够适用于HBM的封装,公司有关产品已通过客户验证,现处于送样阶段,有望受益国产材料替代。
《信息技术-算力系列报告(一):AI服务器催化HBM需求爆发,核心工艺变化带来供给端增量-太平洋[张世杰,李珏晗]-20240125【26页】》